
在当前科技飞速发展的时代,智能手机、平板电脑等电子产品正以惊人的速度更新迭代。与此同时,5G、物联网和可穿戴设备的市场规模也在持续增长,带来了无尽可能。这些电子产品不仅变得越来越小巧,还具备了更多强大的功能,满足日益多样化的使用场景需求。而这也为电子元器件如何做到更小、更薄且具备更强的性能带来了挑战。
由于不同的国家和地区使用了2G、3G、4G、5G的Sub-6GHz甚至毫米波等信号频段来支持当地用户通信互联,因此,手机内部射频器件(射频开关、滤波器、功率放大器、低噪声放大器等)数量需不断提升。射频前端向高密度集成化发展,需要在有限的封装空间内集成多颗射频前端芯片。高密度系统级封装(SiP)作为开启数智化未来的重要技术,实现多种功能芯片的异质异构集成,以并排、堆叠或者双面集成芯片与元器件的多元封装方式,实现更小的尺寸、更高的集成密度和更高/完整的性能。
甬矽电子自成立以来,始终坚持研发及技术创新和工艺改进,在高密度SiP技术开发中,研发实现先进的双面SiP(DSM-BGA SiP)技术,将传统XY平面芯片与元器件集成技术向空间Z方向延伸,实现SiP模组芯片、元器件、射频器件的双面高密度集成整合封装技术,与传统的单面SiP封装相比,能有效减小模块体积,DSM-BGA SiP模组具有更完善系统功能。甬矽电子在研发过程中取得了一系列的技术突破。
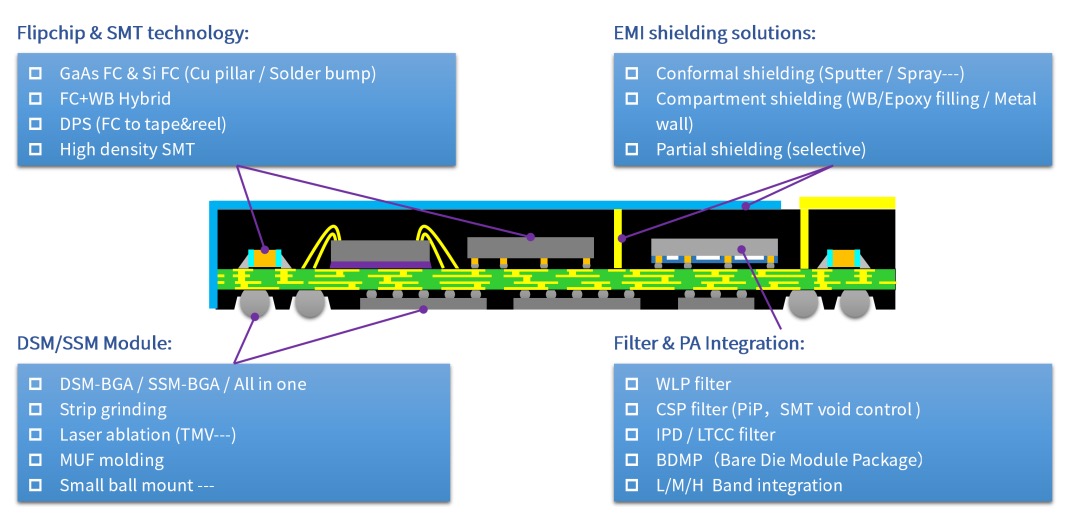
甬矽电子DSM-BGA SiP技术图示
甬矽电子高密度SiP集成方案:
1.高密度倒装(FC)、正装(DB)引线键合(WB)与表面贴装(SMT)技术:
利用FC、DB、WB及高密度SMT,实现芯片、元器件、射频器件等在同一封装体内的高密集成,以及GaAs FC芯片与Si FC芯片的异质集成,通过优化的设计仿真技术,确保多模块在同一封装体内性能的兼容性和可靠性。
2.电磁干扰屏蔽技术:
通过溅镀(Sputter)、喷涂(Spray)等方式在封装体最外侧形成微米级厚度的金属屏蔽层(共形屏蔽,Conformal shielding),及通过植入金属体形成隔离墙(分区屏蔽,Compartment shielding)的多种工艺方式结合,完美解决高密度模组封装内部器件之间的电磁兼容性问题。
3.双面封装技术:
采用优化芯片互联设计,提高空间利用率,以及通过高精度研磨减薄技术(Strip grinding)对双面SiP封装厚度进行精确的厚度控制,进一步减小封装体体积。采用镭射激光技术(Laser ablation)去除焊球周围塑封料,保证焊球的焊接可靠性。
4.射频前端器件的集成设计:
通过WLP/CSP/IPD/LTCC filter与L/M/H频段模组的集成、以及BDMP覆膜等技术手段实现的高性能、高集成和低成本的封装芯片,再二次进行整合集成SiP模组技术。
甬矽电子作为国内前列的IC封测企业,已将高密度SiP封装技术应用于5G全系列射频前端集成模组(DiFEM、LPAMiD、PAMiD、PAMiF、L-FEM、MMMB、TxM、PAM等)、IoT物联网通讯等产品中,并布局进阶Phase 8的L/M/HB All-in-one大集成5G射频模组技术开发。公司正同步加速研发更加先进的封装技术Fan-out,2.5D、3D封装,Chiplet技术,实现芯片在基板上的异质异构互连与多芯片的高密度堆叠,打破集成电路封装极限,开发高性能、高算力、高集成密度的先进晶圆级封装技术。

针对5G射频通信、智能物联网终端和车载电子等应用市场所使用的射频前端芯片、传感器芯片、功率芯片、运算芯片和存储芯片等,甬矽电子的高密度SiP集成方案,均具有显著的优势。未来,甬矽将继续致力于研发先进技术方案,为国内外客户提供更多的选择,更高性价比的方案,以及更完善、更优质的技术服务。








