当半导体制造工艺演进到22nm及以下节点时,随着多重图形技术的引入,对不同工艺层之间套刻(Overlay)误差的要求变得越来越高。套刻测量技术可分为基于像面图像识别测量技术和基于衍射原理的DBO(Diffraction Based Overlay)测量技术。相比于基于图像识别的方法,基于衍射的套刻误差测量具有更好的测量结果重复性、更低的设备引起测量误差TIS(Tool Introduced Shift)、可适应更小的特征尺寸等特点,成为大规模集成电路22nm及以下工艺技术节点所广泛采用的套刻测量方式。
为了测量套刻误差,在晶圆上需要专门设计特定的套刻标记,套刻误差装置测量的性能很大程度上取决于套刻标记的设计。基于计算光刻的DBO套刻标识优化工具可以仿真套刻误差测量的关键指标,从而基于仿真结果可以给出具有更佳表现的套刻标记设计方案,进而缩短标记研发的周期并提高整个光刻过程的效率和质量。
东方晶源基于坚实的计算光刻平台PanGen®推出了DBO套刻标记仿真优化产品PanOVL,可以对套刻标记从多个关键指标维度展开计算仿真。同时考虑大规模仿真海量套刻标记的应用场景,PanOVL引入了分布式的计算框架,大大加速了通过仿真寻找更优套刻标记的效率。
东方晶源的PanOVL软件利用PanGen OPC®引擎以及PanGen Sim®严格电磁场仿真引擎,借助GPU+CPU混算平台和PanGen®分布式计算框架,可以进行大规模套刻标记仿真,并综合多个维度的仿真结果优选出表现更佳的套刻标记方案用于实际光刻工艺。PanOVL可以识别具有较大工艺窗口的套刻标记、给出满足良好信噪比并且探测信号抗工艺扰动能力更强的套刻标记,还可以仿真曝光过程像差对套刻标记的影响,提供令套刻测量结果更贴合器件实际情况的套刻标记。
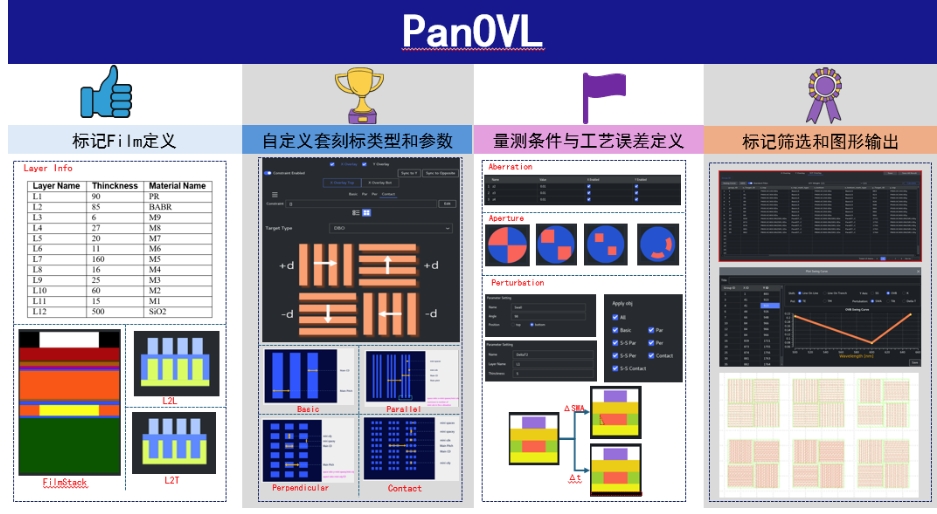
东方晶源PanOVL产品的发布丰富了PanGen®计算光刻平台产品矩阵,同时通过以PanOVL产品为纽带可以加强与产业链上下游的合作,为客户提供更全面的服务,助力客户在晶圆制造能力方面的提升。PanOVL的研发将进一步夯实东方晶源在计算光刻领域的技术全面性和拓展性,为业界带来更加领先、前瞻的晶圆制造EDA解决方案。










