DeepSeek的突破性进展,让中国在AI产业领域似乎迅速缩小了和美国的差距,然而整个国产大模型的运行仍高度依赖英伟达的芯片支持。尽管国产GPU设计能力迅速提升,但随着台积电对中国大陆的供应限制,高端GPU的国产化制造成为中国AI产业发展的关键挑战,尤其是CoWoS先进封装制程的自主化尤为紧迫,目前中国大陆产能极少,且完全依赖进口设备,这一瓶颈严重制约着国产AI发展进程。在此背景下,普莱信智能开发的Loong系列TCB设备,通过与客户的紧密合作,率先完成了国产AI芯片的CoWoS-L测试打样,实现了国产TCB设备在AI芯片CoWoS封装领域的首次突破。
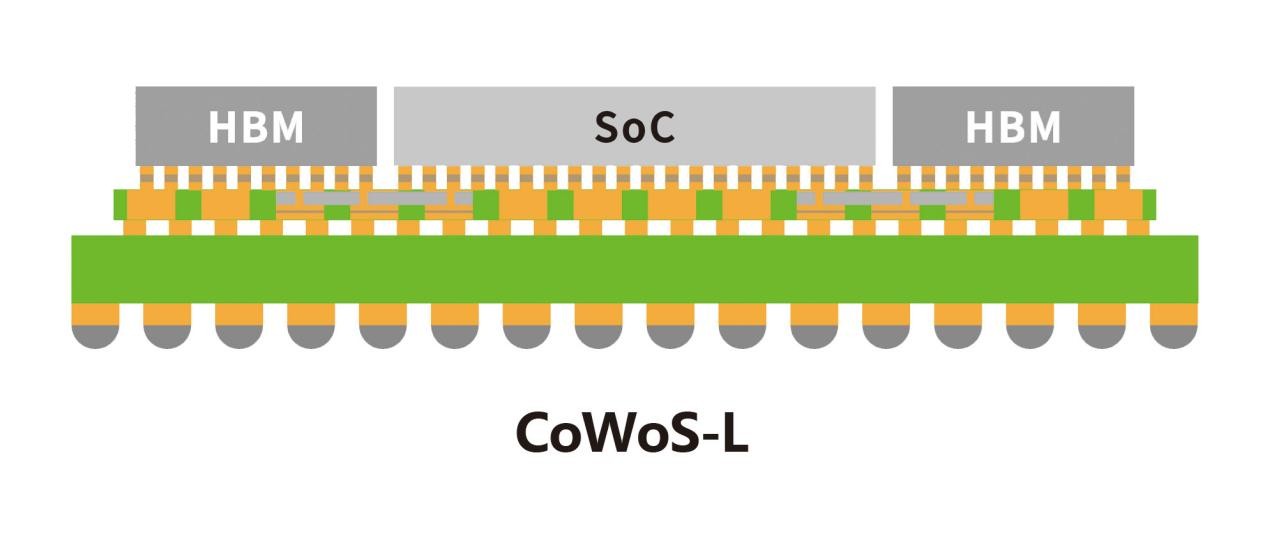
CoWoS封装——AI芯片高密度集成的基石
随着AI大模型、自动驾驶、高性能计算(HPC)的爆发式增长,传统芯片封装技术已无法满足算力密度和能效比的需求。台积电推出的CoWoS(Chip-on-Wafer-on-Substrate)技术,通过将逻辑芯片、高带宽内存(HBM)、硅中介层等异构元件三维堆叠集成,成为AI芯片的“终极封装方案”。其核心优势在于:
1、超高密度互联:利用硅中介层实现微米级TSV(硅通孔)互连,布线密度较传统2D
封装提升10倍以上,突破数据传输瓶颈;
2、极致能效比:HBM与GPU/ASIC芯片的“近存计算”架构,将数据传输功耗降低50%,显著提升能效比;
3、卓越异构集成能力:突破传统封装限制,支持多芯片、多工艺节点(如7nm逻辑芯片+40nm硅中介层)混合封装,为芯片设计提供更大自由度。
TCB设备——CoWoS封装的心脏与技术制高点
在CoWoS封装流程中,热压键合(Thermal Compression Bonding, TCB)是决定良率与性能的核心环节。其作用包括:
1、精准连接:以微米级精度将芯片与中介层或基板对准,通过热压实现铜柱凸点(Cu Pillar)的共晶键合;
2、热应力控制:在高温高压下平衡芯片翘曲,避免微裂纹或界面分层;
3、多层堆叠:支持HBM与逻辑芯片的多次键合,确保信号完整性。
应用于CoWoS封装的热压键合(TCB)设备,精度要求极高,通常不低于±1.5μm,甚至新一代的TCB设备,精度要求达到亚微米,要在这种对温度、压力严格控制环境下,实现稳定的精度和力控,全球现在只有国际少数几家半导体设备巨头能生产TCB设备,如新加坡ASM Pacific、美国Kulicke & Soffa,韩国Hanmi等。同时,随着AI芯片尺寸增大(如英伟达GB200芯片达130×90mm),设备需支持更大键合面积、更高精度及多芯片同步对准,及对无助焊剂封装的要求,Fluxless的键合与自适应翘曲补偿技术成为未来趋势。
全球CoWoS市场爆发式增长,中国需求激增与产能瓶颈并存
据Yole Développement预测,2023年全球CoWoS封装市场规模已突破35亿美元,未来三年将以年均42%的复合增长率快速扩张,预计2026年市场规模将超100亿美元。其中,AI芯片贡献超70%需求——仅英伟达H100/H200、AMD MI300X等旗舰产品,单颗芯片即需1-2片CoWoS中介层,而2024年全球AI芯片出货量预计达150万颗,拉动CoWoS产能缺口持续扩大。

中国作为全球AI芯片第二大市场,CoWoS封装需求正急速攀升:华为昇腾910B、寒武纪思元590、壁仞BR100等国产AI芯片已进入CoWoS量产阶段,单颗芯片中介层需求达2-4片;互联网巨头(如百度、阿里)自研AI芯片亦加速导入CoWoS。
据测算,2024年中国大陆CoWoS封装市场规模将达8亿美元,2026年有望突破25亿美元,年增长率超70%。但核心瓶颈在于包括TCB设备在内的关键设备100%依赖进口,且美国可能将高端TCB设备纳入对华半导体设备禁令,导致产能扩张计划面临“无米之炊”风险。

美国禁令倒逼国产化,TCB设备成AI芯片制造破局关键
美国商务部工业与安全局(BIS)已将CoWoS相关技术列为“重点关注领域”,若对TCB设备实施出口管制,中国大陆先进封装产线或将陷入停滞。例如:ASM Pacific已暂停向部分中国客户供应TCB系列设备;Besi的LAB设备对中国客户实施“逐案审查”。在此背景下,TCB设备国产化不仅是商业需求,更是AI芯片供应链安全的生死线。
普莱信智能——中国TCB设备的“破壁者”
普莱信智能作为国内唯一具备CoWoS级TCB设备自主研发和生产能力的企业,其技术突破彻底改写了国产设备“跟随者”的角色: 其与客户联合开发的Loong系列TCB设备,采用自研“超精密高温纳米运动平台”和“多光谱视觉定位系统”,实现在450度高温,升温速率150度,降温速率50度,±1μm的芯片贴装精度,支持130×130mm超大芯片键合,较国际同行同级别设备效率提升25%;Loong系列兼容晶圆级(12英寸)、板级(620×620mm)封装,支持HBM堆叠等全流程工艺;本次工艺测试的完成,标志着国产TCB设备正式迈入一个全新的阶段。
 更值得期待的是,普莱信正在加速研发下一代Fluxless TCB设备,目标将精度提升至±0.3μm。随着中国CoWoS产能的爆发,普莱信有望在2026年抢占国内TCB设备市场的重要份额,成为全球高端封装装备领域的“中国名片”。
更值得期待的是,普莱信正在加速研发下一代Fluxless TCB设备,目标将精度提升至±0.3μm。随着中国CoWoS产能的爆发,普莱信有望在2026年抢占国内TCB设备市场的重要份额,成为全球高端封装装备领域的“中国名片”。

3月26-28日,SEMICON China展会期间,普莱信(展位号:N1-1285)将携TCB热压键合机Loong(国产唯一HBM/CoWoS键合设备)、巨量转移式板级封装设备XBonder Pro、高速夹焊系统Clip Bonder、多功能超高精度机DA403等亮相。