1.流片地即原产地,美国35座主要晶圆厂汇总!
2.手游技术创新 联发科不做“孤勇者”
3.小米成立芯片平台部?公关部总经理王化回应
4.龙头归来,FPGA能否焕发行业新机?
5.应用材料战略收购荷兰芯片设备商Besi 9%股权
6.韦豪创芯:键合设备-先进封装领域关键设备
7.业内估计,美国关税可能使芯片设备制造商每年损失超10亿美元
8.美国限制英伟达H20芯片对华出口
1.流片地即原产地,美国35座主要晶圆厂汇总!
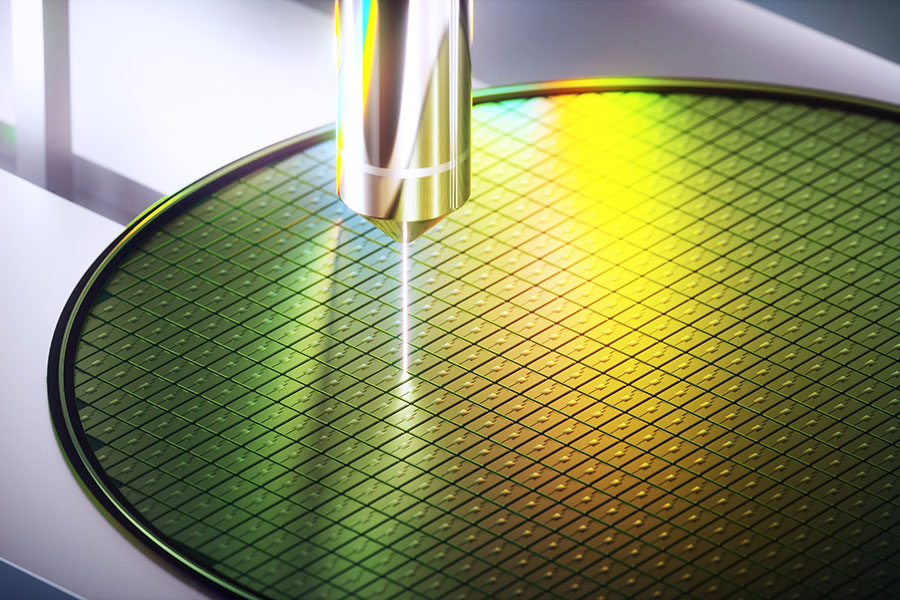
日前,中国半导体行业协会发布《关于半导体产品“原产地”认定规则的通知》称,根据关于非优惠原产地规则的相关规定,“集成电路”原产地按照四位税则号改变原则认定,即流片地认定为原产地。对此,中国半导体行业协会建议,“集成电路”无论已封装或未封装,进口报关的原产地以“晶圆流片工厂”所在地为准进行申报。
近日因中国对美进口产品加征关税,这意味在新规则下,在美国晶圆厂流片的芯片进口国内,将加征关税。集微网统计了位于美国的晶圆厂,以供业内人士参考。
据统计,有四家代工厂在美国有晶圆厂,包括台积电(2座)、格罗方德(3座)、高塔半导体(2座)、X-Fab(1座),有六家IDM公司在美国有晶圆厂,分别是英特尔(4座)、德州仪器(5座)、ADI(3座)、美光科技(3座)、恩智浦(4座)、英飞凌(6座)、三星(2座)。
台积电
台积电是全球顶尖的代工厂,总部位于中国台湾,芯片制造市占率居全球首位,为联发科、苹果、英伟达等知名企业提供代工服务。
目前在美国有两座晶圆厂,分别是位于亚利桑那州的12英寸晶圆厂—TSMC Arizona Corporation和华盛顿州的8英寸晶圆厂—TSMC Washington, LLC及晶圆十一厂。

(台积电亚利桑那州晶圆厂—TSMC Arizona Corporation)
德州仪器
德州仪器内部制造业务历史悠久、遍及全球且呈现区域多元化,在全球15个制造基地中包括多家晶圆制造厂、封装测试工厂以及凸点和探头工厂。目前在美国有5座晶圆厂,主要位于德克萨斯州、犹他州和俄勒冈州。从产能占比来看,TI约90%的晶圆制造由自有工厂完成,且这些晶圆厂主要集中在美国本士。

(德州仪器全球生产基地分布)
ADI
ADI在美国有3座晶圆厂,分别位于马萨诸塞州、华盛顿州和俄勒冈州。该公司正在内部和外部扩大其制造能力,通过内部投资,预计到2025年底其在美国和欧洲的生产能力将翻一番。ADI的晶圆产能中,约30%-40%来自美国本土自有工厂,其余依赖外部代工厂(如台积电、联电)和海外自有工厂(如爱尔兰利默里克)。

英特尔
英特尔不仅是全球顶尖的IDM公司,同时提供代工服务。公司在美国有3座正在运营的制造厂,分别位于亚利桑那州、新墨西哥州、俄勒冈州,另外,还有未来将在俄亥俄州新建一座晶圆厂。英特尔的晶圆产能中,约20%-30%来自美国本土自有工厂,其余依赖外部代工厂(如台积电、联电)和海外自有工厂(如爱尔兰 Fab 34、以色列 Fab 28)。

(英特尔全球制造基地分布)
美光科技
美光科技在全球设有30多个办事处,11个生产基地和13个客户实验室。目前在美国有3个生产制造基地,分别位于佛吉尼亚州、爱达荷州和纽约州。美光的晶圆产能中,约10%-15%来自美国本土自有工厂,其余依赖外部代工厂(如台积电、联电)和海外自有工厂(如日本、中国台湾)。

(美光全球公司分布)
恩智浦
恩智浦在美国拥有并运营着4家晶圆制造工厂,其中两家位于德克萨斯州奥斯汀,另两家位于亚利桑那州钱德勒。晶圆厂的代表性产品包括MCU、MPU、电源管理芯片、射频收发器、放大器、传感器和射频GaN产品。恩智浦的晶圆产能中,美国本土自有晶圆厂产能满足度约30%-40%,恩智浦在美国本土的自有晶圆厂产能主要集中于汽车和工业半导体。

(恩智浦钱德勒射频氮化镓晶圆厂)
格罗方德
格罗方德是一家总部位于美国加尼福尼亚州的半导体晶圆代工公司。该公司最初从AMD制造部门独立而出,公司除会生产AMD产品外,也与IBM、ARM、博通、英伟达、高通等公司合作。
公司目前在美国有三座晶圆厂,分别是位于纽约州马耳他萨拉托加的Fab 8(14nm为主)、纽约东菲什基尔的Fab 10(22nm为主)和佛蒙特州的Fab 9(90nm为主)。

(格罗方德全球公司分布)
三星
三星在美国有2座晶圆厂,奥斯汀和泰勒晶圆厂位于德克萨斯州。美国最大的晶圆厂位于奥斯汀,提供65nm至14nm工艺的晶圆制造。泰勒新建的500万平方米晶圆厂进一步扩展了服务和生产规模。

(三星在美国和韩国的晶圆厂)
英飞凌
英飞凌总部位于德国,主要提供半导体系统解决方案,在美国有6座生产基地,包括制造、组装和生产,分别位于华盛顿、加尼福尼亚、亚利桑那、科罗拉多、德克萨斯和马萨诸塞州。英飞凌的晶圆产能中,约20%-30%来自美国本土自有工厂,其余依赖外部代工厂(如台积电、联电)和海外自有工厂(如德国德累斯顿、马来西亚居林)。

(英飞凌在美国的生产基地分布)
高塔半导体(Tower Semiconductor)
高塔半导体是以色列的一家半导体专业代工厂,专注于为差异化产品提供定制化模拟解决方案,提供尖端工艺技术。
公司在美国(加利福尼亚州纽波特比奇和德克萨斯州圣安东尼奥)拥有两座晶圆厂(200毫米),并可使用英特尔新墨西哥工厂的300毫米产能走廊,主要生产CMOS、CIS、射频模拟、MEMS、电源等。

(高塔半导体三家代工厂)
X-Fab
X-FAB是全球领先的模拟/混合信号半导体技术专业代工集团之一,专注于汽车、工业和医疗应用,总部位于德国。公司目前在美国有1家代工厂,主要生产CMOS混合信号芯片和一系列SiC产品。

(X-FAB全球代工厂分布)
2.手游技术创新 联发科不做“孤勇者”
在2024年全球移动游戏市场以850亿美元收入创下历史新高,30亿手游玩家对沉浸式体验需求持续提升,AI深度创新赋能的背景之下,移动游戏产业正来到技术与体验双重升级的关键节点。
作为手游体验的关键一环,手机芯片厂商该以什么样的姿态面对移动游戏产业新的形势和变革浪潮?在日前举办的联发科天玑开发者大会 2025(MDDC 2025)上,联发科给出了这一行业命题的答案。

从技术底座构建者,到生态构建者和体验推动者转变;从芯片硬件到游戏开发调优和调控、从技术研发到生态落地的全链路布局。这场盛会在为移动游戏产业带来生态创新驱动力的同时,也打造出技术与体验共振的新范式。
以用户需求为原点 助力游戏体验螺旋提升
“体验”正取代“参数”成为游戏芯片的新战场。满帧、稳定、流畅、高画质以及低功耗……如今,游戏性能和体验已成为驱动旗舰手机芯片创新的重要因素和塑造差异化竞争力的重要指标。
联发科天玑系列自问世以来,便不断通过制程工艺的进步、硬件架构创新和软件算法的优化,持续提升对于游戏性能的支持能力。
从天玑9000系列率先支持移动端硬件光追,到天玑9400系列跃升为安卓阵营性能最强GPU,联发科持续推动GPU技术进阶。如今,天玑芯片已在移动端GPU能效与性能上实现双突破,为高帧率与高清画质的精品化游戏体验奠定坚实基础。
自2022年首发移动端硬件光追方案以来,从支持60帧,到率先实现90帧光追,全局光照等,持续探索先进光追技术和生态。推动手游行业画质升级,带来更加沉浸式体验。此次发布的天玑9400+实现了进一步优化,支持更复杂的光影效果,仿生细节再次突破,联发科宣布与《暗区突围》游戏合作已达到PC级骨骼模型效果,标志着移动端向PC级效果进一步的突破。
在速度和流畅性方面,联发科研发的星速引擎自适应调控技术能够让游戏与芯片底层实时 “对话”,明确芯片负载与游戏算力需求,从而动态调配算力资源,带来更优秀的性能和能效表现。不仅获得一众手游厂商的青睐,其优秀的表现更是吸引了Google加入,将该技术引入Android动态性能框架,让全球安卓玩家都能享受到这样的优质体验。
天玑9400+系列通过采用全新升级的倍帧技术,借助True Motion Map Search硬件级算法,可在原生30帧基础上实现60帧体验,相比原生60帧,功耗最高可降低48%,从而实现手机运行重载游戏的 “满帧一条线,功耗一路降”,也改写了 “高性能等于高耗电” 的行业定式。
在强化底层性能之外,联发科也在探索如何通过AI为游戏注入更具想象力的体验维度。围绕端侧NPU能力,联发科正在引领一场“AI x 游戏”的深度融合实践。
比如通过端侧NPU加持下AI能力,联发科围绕天玑平台探索游戏与AI的深度融合。通过与网易伏羲实验室合作,在《永劫无间手游》中实现玩家语音与NPC即时互动;让NPC可以根据语音指令,做出堪比真人队友的实时配合;同王者荣耀、腾讯游戏语音团队合作,在《王者荣耀》中实现端侧AI实时语音转文字功能等,这些范例正在推动移动端全新的交互体验变革。
可以看到,天玑系列所追求的目标,是以提供可感知、更加沉浸式的体验提升为原则,是更为直接和纯粹的用户导向,也因此收获了用户的认同。当前,天玑系列在高端市场表现出强劲的增长势头。调研机构的数据显示,天玑9400系列推动联发科在500美元以上高端机型的份额从2023年的18%提升至2024年的 25%,已成为安卓阵营高端芯片的核心选择。
破解游戏开发痛点 推动研发正向闭环
移动游戏体验跃升的下个重点,不能只靠更强的芯片,更要靠更聪明的协作。当前,移动游戏产业发展一日千里,场景化需求广泛多样,AI时代也使得芯片算力架构变得复杂。如何充分调用释放芯片算力,解决存储以及能效的瓶颈,对于游戏开发者而言,面临不小的挑战。
开发者作为移动游戏产业的重要组成部分,也是联发科在提升游戏体验路上,希望携手的群体之一。近年来,联发科通过持续召开开发者大会,持续迭代开发工具,赋能开发者开发效率的不断提升。
此次大会上,联发科发布的横跨AI应用与游戏的一站式可视化智能开发工具——天玑开发工具集(Dimensity Development Studio)和全新升级的天玑AI开发套件2.0,可以视为在开发工具层面的一次显著进化。
天玑开发工具集包括Neuron Studio和Dimensity Profiler。其中,Dimensity Profiler是一款覆盖CPU、GPU、NPU、内存、功耗等全维度的系统级调试工具,支持微秒级函数追踪,能精准定位掉帧、内存泄漏等问题。开发者还可自定义触发阈值,进行异常记录和回溯分析,全面提升调优效率。让芯片性能可视化,游戏优化有据可依。

Neuron Studio提供开发一站式整合平台,集成模型转换、量化、调优等流程,支持神经网络自动调优与全链路分析。能将万组参数手动调优时间从一周缩短至数小时,极大提升AI模型在端侧的适配效率。
一位合作伙伴游戏团队负责人介绍称,通过Dimensity Profiler可以使优化能力提升数倍,大大加快了项目迭代速度。OPPO AI实验室负责人表示,其团队基于该工具实现MoE技术端侧部署,Token产生速度提升40%。
这种细微问题查找定位和实时监控的一站式能力,能够显著改善目前手游开发者面临的工具碎片化、问题难定位等难题,极大提升了游戏开发者的工作效率,中小团队也可以快速实现端侧AI+光追等高端功能,显著降低开发时间和成本。
实际上,联发科很早便关注到游戏开发者的诉求,并积极与之合作为其赋能,也因此而受益。通过近年来同很多游戏工作室进行深度合作,联发科建立起了一套高效的深度预研合作模式。好处在于,能够找到用户真实关心的场景以及可能存在的问题,从而针对性的进行优化。
这种将工具需求的产生前置于工作室,每一个版本的迭代也都会回归到工作室,真正贯彻了从开发者中来,到开发者中去的初衷,让开发者更加熟悉了解系统、SoC上需要何种能力和调控技术,从而形成开发的正向闭环。比如,在GPU方面,通过动态cache技术,将GPU接口开放给开发者跟OEM合作厂商,做自由调度,从而发挥更多性能。
联发科的价值,不止是技术领先,更是让“顶配体验”走向普及。通过优秀开发工具赋能,硬件效能被最大化开发出来,联发科将多年技术积累外放为全行业的开发红利,让中小开发者也能享用顶级芯片的性能优势,从而加速实现移动游戏行业的创新,推动游戏体验的更上层楼,从这一点上看,手机芯片厂商正在以更加开放的心态拥抱移动游戏产业。
凝聚产业生态 让技术创新事半功倍
无论是对于芯片行业,还是手机和移动游戏产业,“独行快、众行远”这句话同样适用。
生态构建不是锦上添花,而是技术落地的必要条件。在此次大会上,可以看到,荣耀、小米、OPPO、vivo等头部手机厂商,腾讯、网易、米哈游一众手游大厂作为合作伙伴出席,并将创新成果集中展示,联发科的移动游戏生态“朋友圈”堪称全明星级别。

芯片厂商不再只是幕后推手,而要成为体验革新的第一推动者。另一个角度,这也标志着联发科实现从芯片厂商到生态构建者的角色转变。基于对行业发展规律的深刻洞察,在移动游戏产业链高度复杂的今天,单靠技术领先难以形成壁垒,唯有构建开放共赢的生态系统,才能让创新技术快速 “落地生根”。芯片厂商重塑手机、游戏、用户的价值链条,也凸显了其在移动游戏产业生态中的重要地位和价值。
集聚生态的力量联合创新和调优,往往带来事倍功半的效果。
比如针对于倍帧技术,难点在于如何针对motion estimation设计更精确的算法。由于手机端的功耗,尺寸限制,难以像PC端那样有较大的发挥空间,但通过同游戏厂商的合作,联发科直接可以从游戏端获取运动信息进行优化。因此,对于技术创新而言,采用变通的方式,通过良好生态合作的方式,同样可以达到一样的体验效果。
从此次MDDC 2025上释放的信号来看,天玑芯片正在持续突破移动端算力的边界,不断创造流畅沉浸式的游戏体验,开发者工具链与生态合作正在日益完善。
作为全球领先的手机芯片厂商,联发科不仅追求单点技术创新能力,而是追求构建起硬件、软件、生态的全流程竞争优势,这也代表了未来整个移动游戏产业的升级方向。芯片厂商在移动游戏产业中扮演底层基石和生态构建者的重要作用,引领移动游戏产业不断向前。
正如一位行业分析者所言,真正的技术领导力,不仅包括更强的芯片,而是构建技术价值最大化的生态系统。真正的体验革命,本质上是从性能竞赛转向体验重构的转型。不仅是参数、性能的提升,更是让每个玩家都能感受到技术带来的沉浸感与愉悦感。
当技术创新与生态共建形成合力,真正重塑的,不只是画质或帧率的进化,更是玩家与游戏之间的连接方式。联发科用“软硬协同 + 生态共建”的范式证明:只有芯片厂商主动走向以体验为中心,移动游戏产业才可能迎来真正的跃升时代。体验的下一站,不再是算力竞赛,而是“玩家价值”的全面重构。
3.小米成立芯片平台部?公关部总经理王化回应
小米集团公关部总经理王化发文回应小米成立芯片平台部相关消息:刚刚媒体发来问讯,说我司成立了芯片平台部,这事是否有回应?向大家介绍一下手机产品部的芯片平台部一直存在,其部门工作主要是负责手机产品的芯片平台选型评估和深度定制,而负责人秦牧云加入公司都有好几年了,至少我俩2021年就有小米办公的工作聊天记录了。
 有消息称,小米日前内部宣布,在 手机部产品部组织架构下成立芯片平台部,任命秦牧云担任芯片平台部负责人,向产品部总经理李俊汇报。资料显示,秦牧云此前曾在高通任职,担任高通产品市场高级总监,后加入小米。
有消息称,小米日前内部宣布,在 手机部产品部组织架构下成立芯片平台部,任命秦牧云担任芯片平台部负责人,向产品部总经理李俊汇报。资料显示,秦牧云此前曾在高通任职,担任高通产品市场高级总监,后加入小米。
4.龙头归来,FPGA能否焕发行业新机?
FPGA(现场可编程门阵列)作为一种可重构的集成电路,具有灵活性高、并行处理能力强、可扩展性好等优势,在数据中心、5G 通信、汽车电子、工业自动化等领域都有着很强的应用潜力。可是自从Altera(2015年)和赛灵思(2022年)两大龙头企业被收购后,整个行业的发展并不顺利,尽管面对人工智能、自动驾驶等新的机会,市场规模仍然停留在百亿美元左右,并未取得明显增长。不过,最新消息显示,Altera已于4月14日从英特尔独立,重新成为全球最大的独立FPGA半导体解决方案公司。独立后的Altera将获得更大的自主性,亦将深耕数据中心、边缘AI推理等市场。重新迎来龙头回归的FPGA行业,能否焕发新的发展契机?
Altera有望迈入“2.0时代”
Altera成立于1983年,一直专注于设计、开发和销售高性能FPGA、CPLD和结构化ASIC等产品,与赛灵思公司一起被认为是FPGA领域领先的供应商。Altera也不断推出新品,如MAX系列、Cyclone系列和Agilex系列等,满足不同市场需求。
2015年,英特尔以167亿美元收购Altera,将其整合为英特尔可编程解决方案事业部(PSG),期望借助Altera的FPGA技术拓展数据中心和高性能计算市场。然而,在英特尔的组织架构下,Altera的决策流程变得冗长,难以快速响应市场变化,整体发展并不顺利,也拖累了整个FPGA行业的发展创新进程。

新的转机似乎正在出现——英特尔于4月14日宣布将以87.5亿美元估值向私募巨头银湖资本出售Altera业务51%的股份,英特尔保留剩余49%股份。银湖资本将主导Altera的运营。
对此,业界的解读为,Altera有望迈入“2.0时代”。Altera将实现运营独立,半导体行业资深人士拉吉布·侯赛因 (Raghib Hussain) 将担任 Altera 新的首席执行官。拉吉布·侯赛因曾任Marvell产品与技术总裁、Cavium首席运营官,并参与创立网络安全公司VPNet,丰富的履历涵盖芯片设计、商业化及企业战略全链条,具备推动FPGA创新的能力。
银湖资本也对Altera的独立运营也寄予厚望,希望凭借FPGA的硬件可重构特性,在数据中心、边缘AI计算,以及5G基站、自动驾驶、工业自动化等领域取得更多市场机会。
FPGA的停滞与衰微
FPGA尽管在先天上具有很多潜在优势,如上文所述的,硬件可重构、灵活性高、并行处理能力强、可扩展性好等,这在用户需要处理多个任务,实现高度并行计算的时候,比如实现高效的网络加速、存储加速、人工智能模型训练和推理等,具有很大的优势。但是,FPGA作为一个处理器类型,需要克服的问题也不少。
首先,FPGA的一大硬伤是单价过高。FPGA的可编程是用资源冗余来实现的,同样功能的FPGA裸片尺寸是等效ASIC的数倍。资源冗余意味着更高的成本,而成本是需要用户来买单的。
其次,FPGA的功耗较高。FPGA 内部包含了大量的可配置逻辑单元、存储单元和布线资源等。在进行大规模数据处理或复杂算法运算时,需要多个逻辑单元协同工作,每个逻辑单元都有一定的静态和动态功耗,累加起来就会使整体功耗上升。以至于有用户在前期原型验证阶段使用FPGA,后期则转为ASIC,速度可以更快且功耗更低。
第三,FPGA的生态较弱。这与FPGA的硬件编程语言复杂,工具链复杂且不统一,有一定关系;更与当前的FPGA行业缺乏独立大型龙头企业带动相关联。但是,实现任何功能都需要进行编程,如果缺少算法和工具支持,什么都需要客户自己设计,或者找合作方深度定制,这条路就会充满荆棘。

其实,存在问题并不可怕。任何一种半导体产品或技术类型都有先天的优势与劣势。关键是从业企业如何作为。回想当初FPGA刚刚繁荣起来的时候,像极了一位朝气蓬勃的年轻人,到处挤占市场,几乎把手伸向MCU、CPU、DSP、ASSP等处理器的各个领域。然而,时过境迁,现在的FPGA市场行动已经慢了下来。特别是在两大龙头企业被收购后,企业独立性和可获得的行业资源都受到很多限制。
与此同时,竞争对手却在不断更新迭代。AI浪潮下,数据中心云端AI训练与推理、高性能计算、视频处理等任务越来越多地使用通用GPU,而不是 FPGA。过去,互联网云厂商亚马逊AWS、微软Azure等使用FPGA进行网络加速的场景,现在已被通用GPU和定制芯片(如TPU)所取代。
2015年英特尔以167亿美元收购Altera,试图通过FPGA技术增强数据中心竞争力,但该业务始终未达预期。2024财年,Altera的营收仅为15.4亿美元,GAAP(通用会计准则)毛利润3.61亿美元,GAAP运营亏损6.15亿美元。
龙头企业可能有哪些新作为?
Altera 独立或许是FPGA行业重新焕发的一个新契机。根据业界人士的分析,Altera 独立后,公司的运营将更加灵活,可以加大研发投入与创新力度,优化行业生态,将能更加主动地推动市场格局变化,促进市场规模的增长。同时,Altera 独立运营,不必非要选择英特尔作为晶圆供应商,可以有更大的独立自主权。此前Alera独立运营时就得力于与台积电的深度合作。
未来,随着Altera 独立运营工作的展开,首先是应抓住当前边缘AI推理的巨大商机。随着企业运营的节奏日益加快,人们对快速响应的期望日益提升,决策逐渐从数据中心转向网络边缘。更多企业将人工智能和机器学习算法的计算能力及具有 AI 功能的设备安排在边缘,以提升数据处理能力。FPGA丰富的可编程半导体解决方案、软件和开发工具组合,可以提供加速客户技术创新所需的可靠性和灵活性。

其次是推进架构和工艺的创新。用户对芯片产品在资源、性能、功耗、成本等方面的要求是永无止境的。因此,需要小到一家企业、大到一个行业,在系统架构、工艺设计、工具有效性方面进行持续的创新,如此才能不断满足用户需求。
第三是不断完善产业生态和工具链。不管硬件多“牛”,集成多少计算单元,工具链的易用性都是重中之重,用户不会过多关心你的底层架构,丰富好用的工具,方便对底层计算资源调用,同时表现出良好的效率和性能,才是用户最关心的。FPGA厂家必须重视产业生态的建设,只有把生态丰富起来,才可以让用户多起来。
Altera和赛灵思分别被英特尔与AMD并购后,FPGA行业的存在感日渐降低。反而是数家中国本土FPGA厂家,安路科技、高云半导体、京微齐力、成都华微科技等,在中小规模FPGA领域做得有声有色。这种情况下,FPGA行业其实需要一家具有一定实力的行业龙头企业来带动和提振。此次,英特尔因为消化不良而让Altera独立,或许正是FPGA行业迈入新的发展阶段的一次机会。
5.应用材料战略收购荷兰芯片设备商Besi 9%股权

美国芯片设备制造商应用材料宣布,已持有其在人工智能(AI)计算应用项目上的合作伙伴荷兰芯片设备制造商BE Semiconductor Industries NV(简称Besi)9%的股份。
根据发布的一份声明,应用材料公司不打算增持股份,也不会寻求在Besi担任董事。
此次投资是在2020年双方合作开发基于芯片的混合键合技术之后进行的,该技术旨在帮助芯片制造商生产功能更强大、更节能的产品。它被视为一种制造芯片的方法,以推动AI计算的蓬勃发展。
应用材料公司副总裁Terry Lee表示:“我们认为这是一项战略性的长期投资,体现了应用材料致力于共同开发业界最强大的混合键合解决方案的决心。这项技术对于构成AI基础的先进逻辑和存储芯片而言正变得越来越重要。”
6.韦豪创芯:键合设备-先进封装领域关键设备
【编者按】本文由韦豪创芯 张迪 供稿,集微网经授权转发。
随着先进封装在算力时代的重要性日益凸显,键合设备成为不可或缺的关键设备。作为韦豪创芯本期月度思考的重要着眼点,本报告力图对键合设备的发展情况进行梳理,为相关投资提供有益的参考意见。
一、晶圆键合
晶圆键合(Bonding)是将两个或多个晶圆通过物理或化学方法紧密结合在一起的工艺。用以实现芯片连接、减小封装尺寸、或者提高晶圆结构强度,避免晶圆在后续加工中变形等各种用途。
后摩尔时代下,通过芯片制程线宽的缩小提升芯片性能的方式越来越困难,芯片设计端和生产制造端转而通过将器件结构从平面MOSFET改为FinFET/GAA等 “鳍” 状立体结构增加了栅极与沟道的接触面积,提升对迁移电子的控制能力及减少漏电现象。在封装集成方面进行Chiplet异构集成封装、CoWoS、HBM等2.5D/3D封装形式提升互联带宽和集成密度,增强性能的同时能够取得性价比。
先进封装追求更高的传输速度、更小的芯片尺寸,作为先进封装的核心技术,键合工艺经历了从最初通过引线框架到倒装(FC)、热压粘合(TCP)、扇出封装(Fan-out)、混合封装(Hybrid Bonding)的演变,追求更快的互联速度。可以看到键合工艺的改进升级极大的推动了I/O接口密度的提升,也就大幅度提升了芯片的传输带宽。
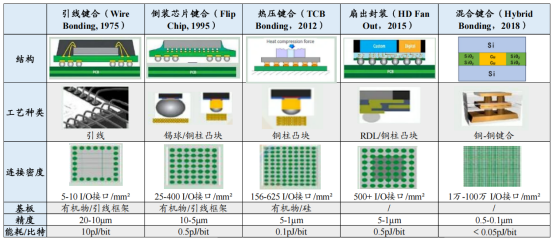
封装形式发展
图片来源:BESI、东吴证券研究所
各大厂商也将先进封装视为关键技术不断推进,例如台积电推出了CoWoS、SoIC等,英特尔推出了EMIB、Foveros 和Co-EMIB等,三星也推出了FOPLP等2.5D/3D堆叠封装技术,海力士、三星、美光等积极投入的HBM存储芯片也同样是采用的3D堆叠方式。封装要求的不断提高,先进封装对键合工艺的要求也越来越高,如更高的键合强度、更好的平整度、更小的键合尺寸等。
二、不同的键合方式的应用场景
① 无图形片的键合
无图形片的键合通常会采用临时键合的方案,临时键合一般有临时热压键合和UV固化两种方式。临时键合首先要将临时键合胶通过旋涂或喷涂方式在器件晶圆和载片表面均匀涂布,随后依靠热压临时键合或UV固化临时键合方式,使载片和晶圆键合牢固。
3D堆叠层数的提高受限于堆叠后的厚度、散热、以及后续的TSV工艺的适配性,晶圆减薄工艺成为先进封装的核心工艺。在一些先进的封装应用中,需要将晶圆减薄至50μm以下,晶圆减薄工艺需要引入临时键合、解键合以提供机械支撑。同时也有部分做碳化硅芯片的晶圆厂,考虑到碳化硅的易碎性,在进行研磨或减薄工艺之前,会通过临时键合叠加一片同尺寸的硅片/玻璃圆片,之后进行研磨工艺,可以大幅降低碎片的风险,之后再进行解键合。
② 有图形片键合/IC芯片的键合
1)高带宽存储器(HBM),垂直堆叠多个DRAM,通过TSV铜连接,可显著提升传输带宽。HBM早期主要采用TC-NCF热压键合工艺,随着堆叠层数的增加,对散热要求越来越高,SK海力士在最新的HBM3E中率先使用改进的MR-MUF工艺,三星和美光仍以TC-NCF热压键合技术为主。在更高层数的HBM生产中各家预期将陆续引入混合键合工艺。
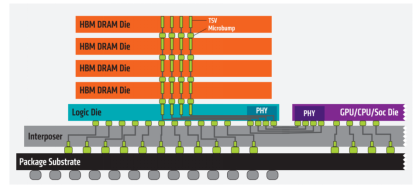
图片来源:AMD、华安证券研究所
2)传统3D NAND架构中,外围电路约占芯片面积的20~30%,随着堆叠层数增加,外围电路面积占比可能超过50%,导致芯片存储密度急剧下降。而长江存储Xtacking技术通过将存储单元和外围电路分别放在两片晶圆上,然后通过垂直互联通道将二者键合。能够显著缓解多堆叠NAND的外围电路占芯片面积,提高存储密度。
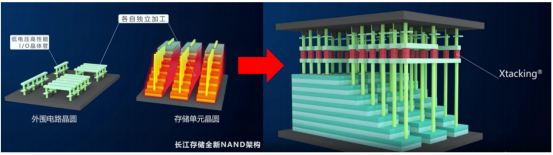
图片来源:长江存储、东吴证券研究所
3)采用同样原理的还有CIS芯片,将CMOS感光单元与逻辑电路分别在不同的晶圆上制作,再将2片/3片晶圆键合连接起来,形成堆叠芯片,这种方式不仅提高了感光面积,提升图像传感器的灵敏度、分辨率等关键指标。还可以将CMOS、逻辑电路采用不同的制程工艺生产,提升效率,降低生产成本。
③ 按键合对象可划分为晶圆-晶圆键合(Wafer-to-Wafer,W2W)和芯片-晶圆键合(Die-to-Wafer,D2W)
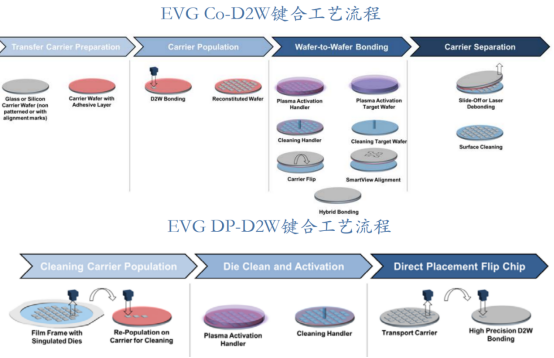
图片来源:EVG、华安证券研究所
1)芯片-晶圆键合(Die-to-Wafer,D2W)
C2W 键合是将单个芯片与整个晶圆进行键合。通常先在芯片和晶圆的表面制备相应的键合层,然后通过施加一定的压力、温度和化学作用等,使芯片与晶圆上对应的位置实现连接。
C2W 键合的灵活性高,可以根据具体需求选择不同类型、不同功能的芯片与晶圆进行键合,适用于小批量、多品种的生产需求,能够快速实现产品的定制化。同时由于是单个芯片与晶圆键合,即使某个芯片存在缺陷,也不会影响其他芯片的键合,只需更换有问题的芯片即可,提高了生产的良率和效率。
但要将单个芯片准确地键合到晶圆上的指定位置,需要高精度的对准技术,否则可能导致芯片与晶圆之间的电气连接不良或机械结合不牢固。另一方面,逐个芯片进行键合,操作步骤较多,相比 W2W 键合方式,生产效率较低,因此在大规模生产时成本相对较高。
2)晶圆-晶圆键合(Wafer-to-Wafer,W2W)
W2W 键合是将两片晶圆直接进行键合。首先对两片晶圆的表面进行处理,使其具有良好的亲水性或形成特定的键合层,然后将两片晶圆精确对准并贴合在一起,在一定的工艺条件下实现晶圆之间的大面积键合。
W2W 键合的生产效率高,一次键合可以完成整个晶圆面的连接,相比 C2W 键合方式,大大减少了键合的次数和时间,适用于大规模生产,能够有效降低生产成本。同时对准精度相对容易控制,由于是两片晶圆整体进行对准,相对于 C2W 键合中单个芯片的对准,更容易实现较高的对准精度,且键合后的一致性较好。
另一方面,灵活性不如C2W 键合,更适合同类芯片进行堆叠,如HBM芯片。缺陷影响范围大,如果其中一片晶圆存在缺陷,那么在键合后整个晶圆的质量都会受到影响,导致整片晶圆报废的风险较高,W2W 键合对晶圆的制造工艺和质量控制要求更为严格。
三、先进封装晶圆键合设备企业
根据YOLE数据,临时键合/解键合设备市场在2027年有望以7%的CAGR增长到1.76亿美元,目前临时键合设备市场规模较小,有待下游生产厂商量产技术突破。键合设备头部厂商BESI预计混合键合工艺将于2025年逐步导入存储器生产,并在2027年左右应用于手机处理芯片。2030年前混合键合设备累计需求预计将超过1400套,对应设备价值量约为28亿欧元。
国内键合设备厂商

在键合设备领域,全球主要的设备供应商包括BESI、K&S(KulickeandSoffa)、ASMPT、EVG和SUSS等,混合键合设备以荷兰BESI,临时键合与临时解键合设备以奥地利EVG、德国SUSS等企业占据主要市场地位,国产替代处于刚起步阶段。
国内拓荆科技、芯源微、青禾晶元、吾拾微、芯慧联等在晶圆键合设备上布局较早:
拓荆科技的键合机系列包括Dione 300和Dione 300F,主要用于3D IC、先进封装和CIS(图像传感器)等领域,该系列设备可实现在常温下多材料表面的晶圆键合。2023年首台晶圆对晶圆键合产品Dione 300顺利通过客户验证,并获得复购订单。混合键合系列产品还包括芯片对晶圆键合表面预处理产品以及键合套准精度量测产品。
芯源微推出了临时键合机KS-C300-TB及激光/机械解键合机KS-S300-DBL/DBM,主要针对 Chiplet 技术解决方案,兼容国内外主流胶材工艺,能够适配60μm 及以上超大膜厚涂胶需求,可实现高对准精度、高真空度环境、高温高压力键合工艺,键合后产品TTV 及翘曲度表现优异,适配开发的机械、激光解键合技术。
青禾晶元近期发布了全球首台独立研发C2W&W2W双模式混合键合设备SAB 82CWW系列,可用于存储器、Micro-LED显示、CMOS图像传感器、光电集成等领域。该产品采用灵活的模块化设计,将C2W和W2W两种技术路线集成到一台键合设备里面,同时可以兼容8寸、12寸晶圆键合,SAB 82CWW系列提供片间同轴和红外穿透两种对准方式,应对不同尺寸和材质的芯片,实现对准精度±30nm、键合精度±100nm的,C2W单键合头UPH最高可达1000片/小时。通过创新键合技术,青禾晶元的键合设备能够满足Micro-LED对亚微米级对准精度和高可靠性的需求。同时青禾晶元还布局了临时键合、解键合等设备,也可用于自研的异质碳化硅衬底的生产中。

(青禾晶元推出的SAB 82CWW系列混合键合设备)
芯慧联开发的3DSIXI晶圆混合键合设备,适用于12寸晶圆熔融键合及混合键合,可集成对准精度检测和气泡缺陷检测,适用于CIS、3DNAND、DRAM、先进封装。开发的晶圆熔融键合设备,可用于硅、玻璃的基板材料,适用于BSI、半导体光学领域。
吾拾微推出了WSBOND-1000 系列晶圆键合机,是国内较早开始研发键合设备的公司,已开发了临时键合、解键合、以及永久键合设备,目前主要应用在碳化硅、无图形片的键合。吾拾微的键合工艺较为灵活,支持多种键合工艺,如热压键合、共晶键合、阳极键合等,可以根据不同的键合材料和工艺要求,灵活选择合适的键合方式。
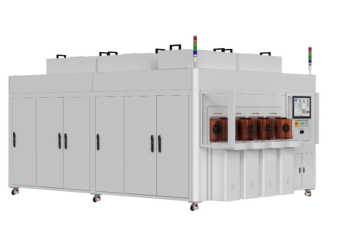
(吾拾微电子推出的12英寸晶圆永久键合设备WPB-Heracles300)
也有业内的键合设备厂商反馈,目前产线购买使用的键合设备,很少有同样型号的复购,一部分原因是国内厂商尚未跑通工艺,同时键合设备面向的领域也不一样,HBM、CIS、CoWoS等不同类型的堆叠形式,各家客户也都在摸索适合自己的键合方式,所走路线会有所不同,也就注定了现阶段,键合设备偏向定制化,小批量的模式,键合设备的批量化,需要下游的生产厂商与键合设备厂商、减薄设备厂商、材料厂商等通力合作跑通量产工艺。
投资建议:
从目前主流的技术路线来看,键合设备是对先进封装的核心关键设备之一,对突破HBM、CoWoS、高端CIS等领域的高端集成芯片是必不可少的,具有向前发展的必然性。同时国内量产工艺路线经过4年多发展,部分头部制造厂已取得一定成绩,但到量产应用还有一定时间。
同时考虑临时键合设备市场空间较小,建议关注非单一临时键合/解键合设备厂商,同时还能够做永久键合、混合键合设备,或者制做其他设备的厂商。
考虑到键合设备厂商与下游各类2.5D/3D先进封装制造端的深度绑定程度,待未来2.5D/3D堆叠工艺取得突破,必将带动一起合作开发堆叠工艺的键合设备厂商,建议关注从早期就介入键合设备赛道,并已取得客户验证的键合设备厂商,如拓荆、芯慧联、青禾晶元、吾拾微等。
风险提示:
(1)国产封装厂商及键合设备厂商发展不及预期的风险,等待期漫长;
(2)下游封装厂商可能会优先选择国外设备先期突破,国产键合设备厂商作为backup二供;
(3)行业竞争加剧,已有多家国内企业进入键合设备的赛道,但作为新技术的研发类设备,量产路线尚未完全打通,未来很可能出现一家先突破,赢家通吃的情况,建议深入考察标的公司。
(来源: 韦豪创芯)
7.业内估计,美国关税可能使芯片设备制造商每年损失超10亿美元
两位知情人士表示,根据上周立法者、政府官员、芯片行业高管以及国际贸易组织SEMI的官员讨论的关税成本计算,美国总统特朗普的新关税可能使美国半导体设备制造商每年损失超过10亿美元。
消息人士称,美国最大的三家芯片设备制造商--应用材料公司、泛林集团和科磊,每家可能会在一年内因关税遭受大约3.5亿美元的损失,Onto Innovation等规模较小的竞争对手也可能面临数千万美元的额外支出。
这些公司生产一些世界上最受欢迎的芯片制造设备,这些设备可能需要数千个专用零件。
在美国前总统拜登实施的先进半导体制造设备的出口管制后,芯片设备制造商已经损失了数十亿美元的收入。
特朗普政府已基本暂停了4月份宣布的互惠关税。但为了刺激美国制造业,政府正在考虑对芯片行业进一步征收关税,并于周一启动了对该行业进口产品的调查。
上周在华盛顿讨论的预估成本包括收入损失(主要由于错失向海外竞争对手销售低端设备的机会),以及寻找和使用替代供应商供应芯片制造工具复杂部件的成本。预估成本还包括关税合规成本,例如增加人员来处理遵守规则的复杂事宜。
与此同时,美国的出口管制刺激了中国对国内芯片设备产业的投资。
8.美国限制英伟达H20芯片对华出口
英伟达公司表示,美国政府正在限制其H20芯片向中国的出口,这将阻碍该公司为满足之前的限制而设计的产品线。
英伟达周二在一份监管文件中表示,美国政府周一通知该公司,H20芯片向中国出口需要获得许可。政府表示,新规旨在解决“受监管产品可能被用于或被转移到中国超级计算机”的担忧。
据悉,虽然H20可以用来开发和运行人工智能软件和服务,但它是一款小型化产品。
英伟达称,进一步收紧限制只会加强中国摆脱对美国技术的依赖的决心,并会削弱美国公司。








评论
文明上网理性发言,请遵守新闻评论服务协议
登录参与评论
0/1000