近日,上海交通大学联合中国科学院上海硅酸盐研究所,发现了一批在低温(约200℃以下)具有良好塑性变形和加工能力的无机半导体材料,进而针对室温脆性半导体创新性地运用经典金属“温加工”方法制备出高质量、自支撑、厚度可调的高性能半导体薄膜,并在此基础上研制出高输出功率密度热电器件。该成果为脆性半导体的加工制造提供了新的路径。相关工作以“Warm Metalworking for Plastic Manufacturing in Brittle Semiconductors”为题发表在《自然 材料》(Nature Materials)上。上海交通大学魏天然教授、上海硅酸盐所史迅研究员与陈立东院士为论文的共同通讯作者,上海交大博士后(现上海硅酸盐所助理研究员)高治强博士、上海硅酸盐所杨世琪副研究员、上海交大马玉鹏博士为论文的共同第一作者,上海交大曾小勤教授对工作给予了指导。
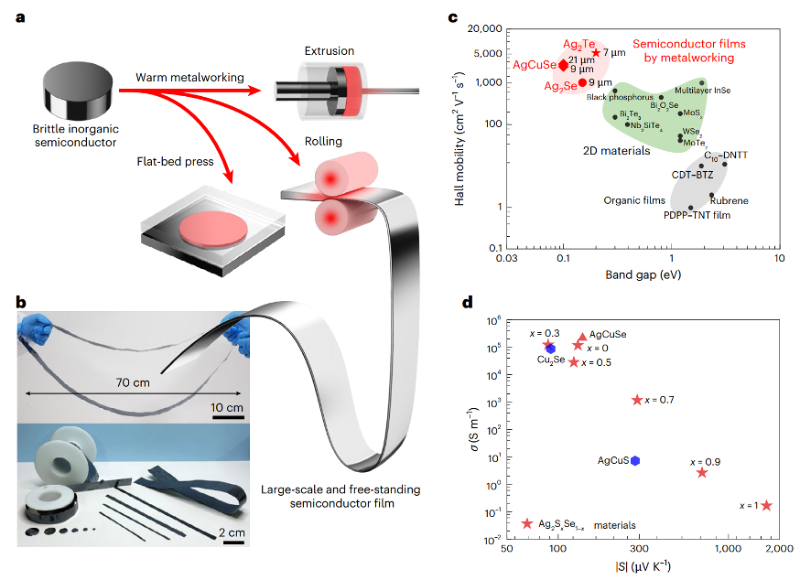
图1.无机半导体材料的塑性“温加工”。(a) 塑性温加工方法示意图,包括但不限于辊压轧制、平板压、热挤压等;(b) 通过温辊轧获得的米级Ag2Se半导体膜;(c) 温辊压制备的无机半导体材料与典型二维材料、有机半导体材料的室温迁移率与带隙;(d) 温辊压半导体膜的电导率 (σ) 与泽贝克系数 (S),其中n型和p型材料分别用红色与蓝色标记
无机半导体材料因丰富可调的功能特性得到广泛应用,但室温下通常表现为脆性。因此,半导体材料和器件难以像金属一样进行高效塑性加工,而是广泛依赖一系列高度精细制备和精密加工技术,如薄膜沉积、光刻、刻蚀、化学机械抛光等,不仅需要高洁净度加工环境、复杂工艺流程、高成本设备等,而且还易造成材料成分偏析从而影响物理性能等问题。近年来,人们陆续发现了一些具有室温塑性的无机半导体材料(如Ag2S、InSe晶体等),为变革其加工制造方法提供了潜在路径。然而,具有室温塑性的半导体材料仍较稀少、物理性能高度趋同化,无法满足半导体材料广泛的应用需求。因此,在数量极为庞大、种类和性能丰富多样的脆性半导体中实现塑性变形和加工,具有极为重要的科学价值和应用前景。
温度是诱导塑性形变的一个重要因素,绝大部分材料在高温下趋向于更软、更易塑性成型。然而,绝大多数半导体和陶瓷等无机非金属材料的“韧脆转变温度”过高(约熔点的0.5-0.7倍,500-700℃以上),热加工难度大、成本高。研究团队发现,一系列典型的窄禁带无机半导体(如Cu2Se、Ag2Se、Bi90Sb10)可在略高于室温的条件下(400-500 K)进行辊压轧制、平板压、挤压等塑性“温加工”(图1)。例如在420 K下辊轧得到的Ag2Se条带可达0.9米长,对应轧制延伸率高达3000%。值得一提的是,这些塑性加工后的材料保留了块体优良的物理性能。例如,厚度仅为数微米的Ag2Se、Ag2Te、AgCuSe等辊压膜的迁移率高达1000-5000 cm2/Vs,显著高于多数二维材料和有机薄膜。因此,与溅射、蒸发和化学气相沉积等无机半导体经典制备技术相比,塑性温加工方法在制造高质量半导体膜方面具有显著优势。第一,该方法可制备自支撑的膜,无需衬底,避免了衬底带来的各种限制和额外成本;第二,该方法能够在微米至毫米范围内自由调控薄膜厚度,这对于制备大尺寸、厚膜的制备尤为有利;第三,工序简单,无额外添加剂或溶剂,所制备的薄膜结晶性好、元素分布均匀,同时很好地继承了块体材料优异可调的物理性能。
塑性温加工后的材料表现出丰富的微观组织结构。如图2所示,温压缩后材料表面广泛存在台阶状的剪切带,断面表现出明显的韧窝;剪切带内部包含明显的晶格扭转、层错等微结构,位错密度较低。对于温辊轧后的样品,材料发生织构化,原始的大晶粒沿着变形方向被拉长并发生破裂,样品内部同样观察到较低的位错密度。这说明,此类材料在略高于室温下发生塑性变形的机制不以位错为主导,而主要依赖于晶粒的重整变形以及晶格的扭转畸变。

图2. 塑性温加工形变对应的微观组织结构。(a) 温压缩后Ag2Se表面上的剪切带;(b) 升温断裂后Ag2Se断口表面上的韧窝;(c) Ag2Se表面剪切带的高分辨透射电子显微镜图像;(d) Cu2Se在温辊压前(上图)和温辊压后(下图)的透射电子背散射衍射(TKD)图像;(e) 温辊压后Cu2Se的透射电子显微镜图像;(f) 温辊压后Cu2Se的高分辨透射电子显微镜图像
上述丰富的微结构机制反映了普适的塑性变形原理,即材料极易滑移、难解理。在极低温度下,材料中原子几乎被冻结,振动幅度小,即使金属也表现出显著的脆性;随着温度升高,原子振动幅度增大且晶格膨胀,原子、晶面、缺陷等结构单元更易发生相对位移,材料易产生塑性形变;当温度接近熔点时,原子振动更加剧烈,甚至在可以一定范围内流动,材料因此具有显著的塑性变形能力。以上物理图像可用解理能(Ec)和滑移能垒(Es)进行量化,两个参量分别代表了材料抵抗断裂和发生变形的能力。研究团队首先计算了0 K下系列材料的Ec和Es值。当温度升高时,加剧的原子振动导致相邻原子之间更容易成键和断键,滑移能垒Es显著降低;而解理能Ec随温度降低并不显著。团队基于前期工作,进一步建立了解理能和滑移能垒随温度的依赖关系,并以两者比值(Ec/Es)作为经验性的塑性因子,建立了描述温度相关的塑性形变物理模型(图3)。基于典型材料的实验结果,该模型给出了韧脆转变对应的Ec/Es因子的临界范围(~4.6-5.3)。该模型可计算与预测无机非金属材料的韧脆转变温度,发现了一批具有低韧脆转变温度(小于500 K)的半导体材料,包括Ag2Se、Ag2Te、Cu2Se、AgCuS、AgCuSe等,与实验数据高度吻合。

图3. 无机半导体的变温塑性机制与模型。(a) 不同温度下初始结构与滑移后结构的示意图;(b) 解理能与滑移能垒随温度的变化趋势图;(c) 理论计算得到的典型材料的解理能/滑移能比值与温度的关系,其中黄色高亮区域为韧脆转变对应的阈值区间;(d) 多种材料的实验与理论韧脆转变温度值
塑性温加工方法获得的高性能自支撑半导体在电子和能源器件方面有着广阔的应用前景。以热电能量转换为例,该工作选取了其中三种高性能热电材料的辊压薄片(厚度约100微米):Cu2Se、Ag2Se、Mg3Bi1.5Sb0.49Te0.01。采用表面喷砂粗化和磁控溅射工艺在薄片上下表面构筑功能化金属层,之后经过热电臂切割、转移和一体化集成焊接等工艺,研制了两种面外型薄膜热电器件,其中器件1#由17对p-Cu2Se与n-Ag2Se组成,填充率27.5%;器件2#由6对p-Cu2Se与n-Mg3Bi1.5Sb0.49Te0.01器件组成,填充率54.5%(图4)。得益于热电薄片的高功率因子以及热电臂-电极间的高强低阻界面,两种器件的最大归一化功率密度达到43-54 µW cm-2 K-2,约为先前报道Ag2S基薄膜热电器件的2倍。

图4. 基于温辊压薄片的高性能热电器件。(a) 器件制备流程示意图;(b, c) 两种热电器件在不同有效温差下的电压-电流(V-I)及功率-电流(P-I)输出曲线;(d) 两种热电器件在不同有效温差下的最大归一化功率密度
该工作建立了无机半导体温度依赖的塑性物理模型,在脆性半导体中实现了类金属的塑性加工,为丰富无机半导体加工制造方法、拓展应用场景提供了重要参考。工作得到了国家重点研发计划(2024YFF0505900)和国家自然科学基金(T2122013、52232010、92463310)的支持。








评论
文明上网理性发言,请遵守新闻评论服务协议
登录参与评论
0/1000