近日,硅来半导体(武汉)有限公司(以下简称“硅来半导体”)首批兼容12英寸碳化硅衬底的激光剥离全自动化设备顺利交付客户。本次交付标志着硅来半导体超大尺寸碳化硅衬底激光剥离全自动化技术成功通过产业化检验,更彰显了这家低调深耕、实力突出的企业硬核底蕴——在技术储备、研发创新、量产交付、全周期服务四大核心维度均达到行业顶尖水平,将为碳化硅产业高质量发展注入强劲新动能。
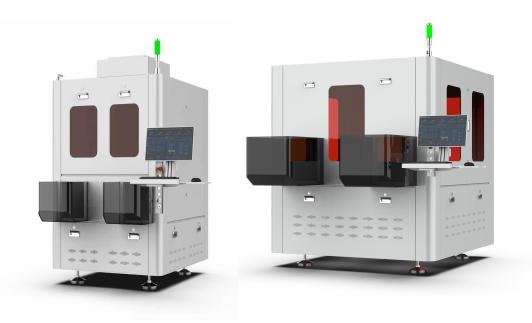
超大尺寸碳化硅衬底前景广阔,产业升级核心方向
作为第三代半导体代表材料,碳化硅具有禁带宽度大、熔点高、热导率高等性能优势,在高温、高压、高频条件下表现优异,广泛应用于新能源汽车、智能电网、5G通信等领域,并有望作为理想的AR镜片材料、先进封装中介层材料等推动多个领域的技术变革。与6英寸衬底相比,8英寸和12英寸碳化硅衬底能够进一步扩大单片晶圆上可用于芯片制造的面积,在同等生产条件下,可以显著提升产量、降低成本。
自主创新破局,核心技术兼具独创性与先进性
碳化硅莫氏硬度高达9.5,接近金刚石,传统切割工艺加工难度极大、效率低下。硅来半导体深耕激光精密加工细分领域,依托强大的综合实力,自主突破技术壁垒,先后推出6英寸、8英寸、12英寸碳化硅衬底激光剥离全自动化量产设备,彻底解决大尺寸及超大尺寸碳化硅衬底加工的行业痛点,核心技术的独创性与行业领先性全面凸显。
公司自主创新激光剥离工艺技术领先
硅来核心研发团队来自华中科技大学激光学科,技术创新能力强,且深耕激光产业多年。
团队自主创新激光剥离技术,针对莫氏硬度高达9.5,接近于金刚石的SiC单晶,
先后推出6英寸、8英寸和12英寸碳化硅衬底激光剥离量产设备,解决了大尺寸、尤其是超大尺寸碳化硅衬底加工的技术难题,效率和损耗显著优于传统线切割工艺。关键技术效果如下:

高加工效率:单片激光剥离时间<15分钟@8英寸,较传统线切工艺提升20-30倍;
低原料损耗:单片加工损耗碳化硅晶锭60-80μm@8英寸,较传统线切工艺降低60%,且加工过程中不使用任何耗材及化学试剂;
高出片率:相较传统线切工艺,出片量提升30%,单片加工成本降低50%。
公司激光剥离工艺技术的差异性明显
硅来碳化硅衬底激光剥离设备不同于行业现有技术路线,体现在:
独创性采用SOC组合光源。相比多台独立光源方案具备更高集成度和稳定性;
搭载自由曲面光路整形技术;
配备“白光干涉面形检测+反演算法补偿”技术:可靠性突出;
支持不同电阻率碳化硅晶体工艺定制,可承载更高能量,且具备“无老化、
无寿命限制、强抗干扰”特性;
同时支持6、8、12英寸规格,定位精度与非标尺寸兼容性满足生产要求;
单台1.2m×1.4m设备即可完成切割全工序与自动上下料。空间布局更加紧凑,设备尺寸经过深度优化,在保证全自动化高性能运行的前提下,大幅节省车间布局空间,提升厂房整体利用率,适配不同规模产线的布局需求,更高效、更精密、更智能。

公司激光剥离设备获得市场和产业资本高度认可
不到半年时间硅来累计出货数十套设备,广泛覆盖国内多家头部碳化硅企业。得益于模块化的设计和产业协同,硅来半导体已实现规模化量产,设备的批量交付周期为28天,未来有望缩短至14天;
同步布局硅光芯片核心装备领域,自主研发的硅光芯片激光隐切设备已成功出口海外,设备核心性能指标较行业标杆DISCO同类产品实现提升,凭借更高精度、稳定性与性价比,将成为公司未来主力机型之一。
硅来已经成功引入武汉帝尔激光科技股份有限公司等战略投资者。作为全球领先的激光精密微纳加工装备制造企业,帝尔激光始终坚持原始创新,深耕激光技术应用“无人区”,在半导体领域已经推出TGV激光微孔、PCB超快激光钻孔、SiC/IGBT激光退火、激光隐切等多款设备。未来,硅来将聚焦半导体激光装备核心赛道,持续优化SoC光源、自由曲面光路等核心技术,深化与帝尔激光的协同创新,以更先进的技术、更优质的服务赋能碳化硅衬底产业发展。









